欢迎您注册蒲公英
您需要 登录 才可以下载或查看,没有帐号?立即注册
x
二次离子质谱(Secondary Ion Mass Spectroscopy,SIMS)是现代表面分析技术中重要的组成之一。它是利用一次离子束轰击材料表面,通过质谱分析器检测溅射出来的带有正负电荷的二次离子的质荷比,从而得到样品表面元素组成的一种表面分析技术。和AES、XPS、EDS等技术相比,SIMS可以获得材料更加表面的元素信息(1nm),同时具有极高的元素检出限(可以达到ppm甚至ppb级别)。SIMS技术不仅可以得到元素组成信息,也可以用于分析同位素、原子团、官能团或者分子结构信息。因此其既能用于分析无机材料,也可以用于分析有机物大分子,这使其广泛应用于微电子、材料、化工、生物医药等领域。 
SIMS技术理论上可以完成元素周期表上含氢元素在内的所有元素的低浓度半定量分析,同时还具有亚微米级(<100nm)的离子成像空间分辨率。SIMS的质谱分析器分为四极杆质谱(QMS)、磁质谱(MMS)、飞行时间质谱(TOF),其中TOF-SIMS是当前表面分析技术中分辨率最高的技术。 按照一次离子束的能量和纵向扫描方式,SIMS技术可以分为静态SIMS(SSIMS)和动态SIMS(DSIMS),其中SSIMS要求真空度<10-7Pa,电子束能量低于5keV,同时在低束流密度下对材料微区进行轰击,从而保证只激发出单层原子,以达到超高的表面分辨率。SSIMS的软电离技术可以用于分析有机物,其质谱信息可以得到官能团和有机大分子的分子量,可分析材料表面有机分子结构。带有TOF质谱分析器的TOF-SIMS因其超高的分辨率、灵敏度并且可以同时检测无机物和有机物而被各大半导体公司厂家用于检测硅晶元件的元素定位和表面有机物污染。 而DSIMS则是利用高能量、高密度离子束对材料进行层层剥离,同时检测在不同深度下的二次离子信息,从而动态地剖析材料的元素在三维空间的分布情况。因此DSIMS是一种破坏性较大的表面分析技术,主要用于无机样品的深度剖析、痕量杂质鉴定等,在矿物地质研究、同位素分析、研究半导体元素掺杂等领域广泛使用。 DSIMS的检测深度可以从几纳米到数十微米,可用于薄膜材料、界面等元素组成分析,德国ION-TOF的先进TOF-SIMS仪器,可以提供完善的SIMS技术解决方案。下图为半导体无机材料膜层的DSIMS深度剖析曲线图案例,从图中可以显著的观察到材料表面300nm下Si元素和Ge元素的分布情况。 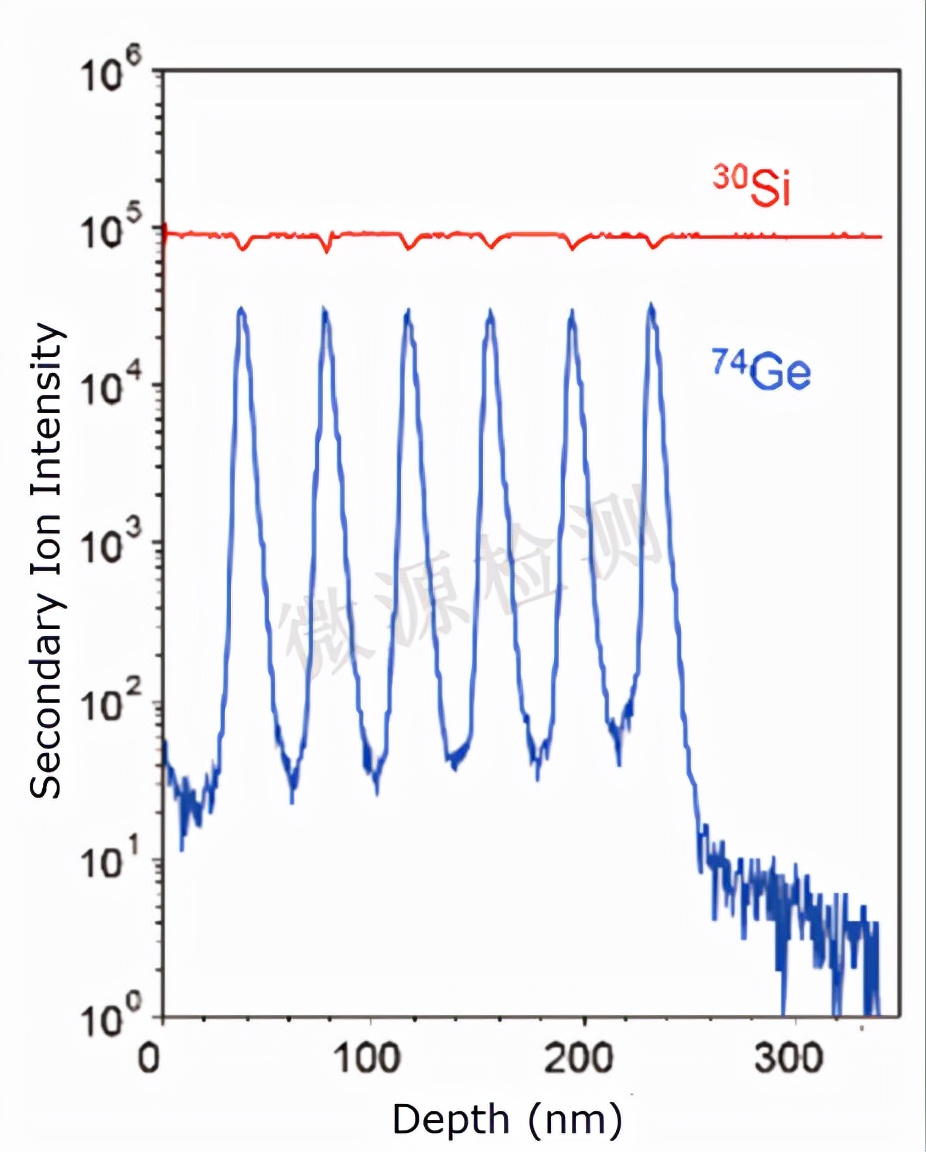
|  |手机版|蒲公英|ouryao|蒲公英
( 京ICP备14042168号-1 ) 增值电信业务经营许可证编号:京B2-20243455 互联网药品信息服务资格证书编号:(京)-非经营性-2024-0033
|手机版|蒲公英|ouryao|蒲公英
( 京ICP备14042168号-1 ) 增值电信业务经营许可证编号:京B2-20243455 互联网药品信息服务资格证书编号:(京)-非经营性-2024-0033